制造的后道工序,分为封装与测试两个环节,是提高集成电路稳定性及制造水平的关键工序。
集成电路封测是集成电路产品制造的后道工序,指将通过测试的晶圆按产品型号及功能需求加工得到独立集成电路的过程。
(1)封装环节将集成电路与引线框架上的集成电路焊盘与引脚相连接以达到稳定驱动集成电路的目的,并使用塑封料保护集成电路免受外部环境的损伤;
(2)广义的半导体测试工艺贯穿集成电路设计、制造、封测三大过程,是提高集成电路制造水平的关键工序之一。封测环节的测试工艺特指后道检测中的晶圆检测(CP)及成品检测(FT)。


中国集成电路封测行业发展可分为五个阶段。当前,中国封装企业大多以第一、第二阶段的传统封装技术为主,例如DiP、SOP等,产品定位中低端。
中国集成电路封测行业发展可分为五个阶段。当前,中国封装企业大多以第一、第二阶段的传统封装技术为主,例如DiP、SOP等,产品定位中低端。随着中国封测技术的创新步伐加快,QFN、BGA、WLP、SiP、TSV、3D等先进集成电路封装形式逐渐进入量产阶段。自第三阶段起的封装技术统称为先进封装技术。先进封装技术更迎合集成电路微小化、复杂化、集成化的发展趋势。

中国集成电路封测上游主要参与者为。中国晶圆制造厂商多为代工厂,实力强劲。下游新兴应用市场的增长为封测行业增长的主要驱动力。
集成电路封测上游厂商包括晶圆制造厂商及封装材料厂商,下游应用市场可分为传统应用市场及新兴应用市场。集成电路封测产业运作模式为集成电路设计企业根据市场需求设计出集成电路版图,由于集成电路设计企业本身无芯片制造工厂和封装测试工厂,集成电路设计企业完成芯片设计,交给晶圆代工厂制造晶圆,晶圆完工后交付封测公司,由封测公司做芯片封装测试,之后集成电路设计公司将集成电路产品销售给电子整机产品制造商,最后由电子整机产品制造商销售至下游终端市场。

晶圆制造厂商以Foundary模式为主,全球前十大晶圆制造厂商仅有三星为IDM模式。封装材料的门槛相对晶圆材料门槛较低,中国已实现进口替代。
封测为集成电路制造的后道工序,对加工好的晶圆进行封装,因此晶圆制造代工厂为封测行业上游的主要参与者。
晶圆制造业技术与资金壁垒高,行业集中度极高,全球前十大晶圆制造企业合计营收在全球晶圆制造市场规模的占比在90%左右,有突出贡献的公司包括台积电、格罗方德、三星以及中芯国际等,其中仅有三星为IDM模式,拥有自身的封测产线,台积电的业务也开始向封测领域渗透。
其他巨头晶圆制造企业如中芯国际不具备先进封测技术,需与专业的封测企业合作,完成最后的封测工艺。

除晶圆制造企业,封测行业上游参与者还包括半导体封装材料供应商。封装材料包括芯片粘结材料、封装基板、引线框架、陶瓷基板、键合线及包封材料等,其中封装基板市场顶级规模。2018年,芯片粘结材料、封装基板、引线框架、陶瓷基板、键合线及包封材料市场规模在中国集成电路封装材料市场规模的占比分别为3.9%、38.2%、15.8%、11.3%、13.9%及15.0%。封装材料的门槛相对晶圆材料门槛较低,中国已实现进口替代。

传统应用市场增长放缓,对集成电路产品需求减弱。新兴应用市场增长迅速,成为驱动集成电路产业增长的主要动力。
封装测试企业为芯片设计公司可以提供封测服务,芯片设计厂商将封测后的芯片成本销售至下游终端市场。封装测试行业的下游传统终端应用市场包括消费电子、家用电器、信息通讯、电力设备等行业。
2018年,传统应用市场消耗的封测产品在封测行业市场规模的占比在58%左右,且以传统封测产品为主。中国消费电子及家用电器市场已进入下行周期。
以智能手机为例,中国出货量自2017年起呈现负增长。中国智能手机市场收缩,导致手机设备厂商对芯片需求减弱,拖累中国封测市场增长。

随着5G基站的加速建设及5G通信技术的普及,中国物联网人工智能、超高清市场等新兴市场加速发展。
以物联网为例,5G技术可实现100万个设备/km2连接密度,相比4G技术提升10倍,为物联网发展提供核心技术支撑。中国物联网设备连接量从2014年的5.2亿个增长至2018年的26.0亿个,年复合增长率达49.5%。
随着5G技术的推广,物联网设备数量将维持快速地增长,成为芯片产业增长的主要动力。新兴行业增长迅速,对集成电路产品需求强劲。
2018年,中国封测行业在新兴应用领域的市场规模在封测行业总市场规模的占比在42%左右,有超过封测市场在传统应用领域市场规模的趋势。

封测行业为典型的劳动密集型行业,技术壁垒相比来说较低,市场之间的竞争加剧,行业红利逐渐消散,中国集成电路封测行业的增速放缓。
受益于人工智能及物联网等新兴行业快速地发展及国产替代效应加剧,下游企业对集成电路的需求强劲。根据中国半导体协会统计,2019年前三季度集成电路累计销售额高达5,049.9亿元,同比增长15.3%。
中国集成电路封装测试行业销售额从2015年的1,384.0亿元增长至2019年的2,314.6亿元,年复合增长率为12.0%。
封测行业为典型的劳动密集型行业,技术壁垒相比来说较低,市场新入者增加,行业竞争加剧,导致中国集成电路封测行业的增速放缓。
2019年中国集成电路封测产品销售额同比增长率较去年同期下降15.2个百分点,下滑至5.5%。
2019年至2024年为中国5G基站建设的加速期,为集成电路产业新的需求增长点。中国集成电路封测行业仍可享受5G时代的红利,预计集成电路封测行业市场规模增速较2019年有所改善,维持在7%左右。

封装测试业是集成电路产业的重要组成部分,集成电路产业是电子信息产业的核心,为中国战略性新兴产业。
中国格外的重视和全力支持集成电路产业的发展,先后出台了一系列促进行业发展的政策。
2014年6月,中国国务院印发《国家集成电路产业高质量发展推进纲要》,提出要提升先进封装测试行业的发展水平,推动中国封装测试行业的兼并与重组,开展芯片级封装(CSP)、三维封装、晶圆级封装(WLP)、硅通孔(TSV)等高级封装测试产品的研发与量产。
2015年5月,国务院颁布《中国制造2025》,提出要提升集成电路设计水平,掌握高密度封装以及三位封装技术,提升封装测试行业的发展能力与供货能力。
2018年1月,中国财政部、中国税务总局、国家发展改革委、中国工业与信息化部联合颁布《关于集成电路生产企业有关企业所得税政策问题的通知》,提出对满足规定的要求的集成电路相关企业实施税率减免等政策,加大对行业的支持。

传统封测由于技术壁垒低、同业竞争非常激烈,利润空间极小,未来中国封测行业将向产品附加值更高的高级封测升级。
为满足集成电路更小更轻及集成度更高的应用需求,封装技术由传统的封装技术演变至先进封装技术。传统封装技术包括DiP、PLCC、QFP等。先进封装技术包括BGA、QFN、2.5D/3D、WLCSP及Fan-out等。先进封装技术亦朝着I/O数量更多,尺寸更小及成本更低的方向发展。
2018年中国先进封装营收约为526亿元人民币,占中国集成电路封测总营收的25%,远低于全球41%的比例。
2018年中国封测四强(长电、通富、华天、晶方)的先进封装产值约110.5亿元,约占中国先进封装总产值的21%,其余中国大陆封测企业及在大陆设有先进封装产线的外资企业、台资企业的先进封装产值约占79%。
中国本土先进封测四强通过自主研发和兼并收购,快速积累先进封装技术,但中国整体先进封装技术水平与国际领先水平仍有差距。
传统封测由于技术壁垒低、同业竞争非常激烈,利润空间极小,未来中国封测行业应向产品附加值更高的高级封测升级,资本支出将取代人力成本作为新的行业推动力。
5G时代的到来将推动AI、物联网、智能汽车等新兴应用市场,这些新兴应用对电子硬件提出更高的要求:高性能、高集成、高速度、低功耗、低成本。先进封装技术是解决各种各样的性能需求和复杂结构集成需求的最佳选择。

在消费类电子科技类产品轻、小、短、薄化的市场发展的新趋势下,晶圆级芯片尺寸封装的成本优势愈加明显,将逐步挤占传统封装的市场份额。
以WLCSP(晶圆级芯片尺寸封装技术)为例,传统封装将晶圆先切割成芯片,再对芯片实施单独的封装,而WLCSP封装先对晶圆进行封装、测试作业,然后将封装测试后的晶圆进行切割。
WLCSP封装后的芯片尺寸与裸芯片大小一致,大幅缩小芯片封装后的尺寸,WLCSP封装的产品比传统QFP产品小75%、重量轻85%。此外,WLCSP封装技术大幅减小封装成本。
WLCSP的封装成本按照晶圆数计量,切割后的芯片数不会增加封装成本,而传统封装的封装成本是按封装芯片的个数计量,因此,WLCSP的封装成本随晶圆尺寸的增大和芯片数量增加而降低。
在消费类电子科技类产品轻、小、短、薄化的市场发展的新趋势下,晶圆级芯片尺寸封装的成本优势愈加明显,将逐步挤占传统封装的市场份额。
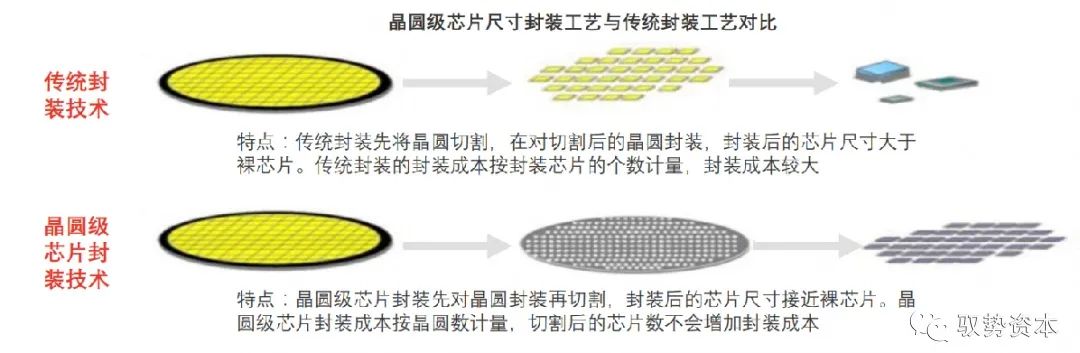
随着先进封装技术的演变,晶圆制造、封测及模组企业的业务相互渗透,存在一定的竞争关系。未来中国封测企业或考虑整合晶圆制造及模组企业。
晶圆制造厂商进军封测行业晶圆级芯片封装(WLCSP)及系统级芯片封装(SiP)为先进封装技术两大主流发展趋势,其中晶圆级芯片封装制程需用到晶圆制造所用技术与设备例如刻蚀、沉积等技术与设备,意味着晶圆制造业与封测行业业务分界模糊,可相互渗透和拓展。
晶圆级芯片封装技术可将晶圆制造、封装测试、模组厂整合为一体,优化集成电路产业链,使得芯片生产周期缩短,进而提高生产效率,降低生产所带来的成本。例如,全球晶圆制造有突出贡献的公司台积电将业务扩张至封测领域,推出InFo集成扇出型晶圆封装技术和CoWoS晶圆基底芯片封装技术。
台积电借助将制造工艺与封测工艺结合一体的优势成功获得苹果公司的订单。台积电当前正在研发系统整合芯片封装技术及晶圆3D堆叠封装技术,预计在2021年可实现量产。
在系统级封装领域,封测企业的业务与模组企业的业务有一定的重合。随着消费电子领域集成电路产品集成度的提升、体积的缩小,部分模组、系统的组装的精度要求逼近微米级别,与封测环节的工艺产生重叠。
欧菲光(O-film)通过收购索尼华南,顺利切入和拥有FC封装技术。欧菲光是目前中国唯一拥有FC封装技术的模组供应商。随着先进封装技术的演变,晶圆制造、封测及模组企业的业务相互渗透,存在一定的竞争关系。未来中国封测企业或考虑整合晶圆制造及模组企业,消除同业竞争并增加协同效应。

中国封测企业通过海外并购快速积累先进封装技术,先进封装技术已与海外厂商同步,但先进封装产品的营收在总营收的占比与中国台湾及美国封测巨头企业存在一定差距。
全球集成电路封测行业竞争格局清晰,按2019年前三季度营收及市占率排名,全球封测厂商可分为三大梯队:
(1)第一梯队的企业包括日月光、安靠、长电科技、矽品及力成。第一梯队封测厂商营收规模均超过500万美元,但营收增长率保持在低位,部分头部封测企业营收呈现负增长;
(2)第二梯队企业包括力成、通富微电、华天科技及京元电子。第二梯队企业营收规模在200万-500万美元之间,市占率小于第一梯队的企业,但第二梯队企业营收增速均保持在2位数增长,显示第二梯队企业仍在快速地发展期,有望进入第一梯队的行列;
(3)第三梯队企业包括联测及硕邦,营收规模在100-200万美元之前,营收增速缓慢,不及第二梯队的企业。
从技术层面分析,中国封测企业业务主要以传统封装为主。中国封测企业通过海外并购快速积累先进封装技术,先进封装技术已与海外厂商同步,BGA、TVS、WLCSP、SiP等先进封装技术已实现量产,但先进封装产品的营收在总营收的占比仍与中国台湾及美国封测巨头企业存在一定差距。
此外大陆封装企业在高密度集成电路封装技术上与国际领先厂商差距明显,如台积电提出的SoC多芯片3D堆叠技术,其采用了无凸起键合结构,可更大幅度提升CPUGPU与存储器整体运算速度。英特尔也提出类似的3D封装概念,将存储器堆叠至CPU及GPU芯片上。在3D 堆叠封装技术领域,中国大陆封测企业有待加强。

中国上市封测企业中重点推荐晶方科技,新三板企业中重点推荐利扬芯片,非上市非挂牌企业中重点推荐气派科技,同时建议关注华天科技及芯哲科技等企业。
项目二期生产厂房顺利结顶,预计于2020年4月份即可完整交付使用。据悉,宿迁厂以脚数较低的IC和功率器件为主,低成本是其
,英文为IntegratedCircuit,缩写为IC;顾名思义,就是把少数的常用电子元件,如电阻、电容、晶体管等,以及这些元件之间的连线,通过半导体工艺
资料pdf下载 /
封装测试业在位于无锡新区的海泰半导体等新建项目投产的带动下,出售的收益实现了10.9%的同比增长,规模为3
产业投资基金总经理丁文武表示,企业并购是集聚人才、获取技术、占领市场的有效方式,大基金将持续推动
产业基地项目(以下简称“项目”)。项目总投资80亿元,分三期建设,主要进行存储器、MEMS、人工智能等
产业基地项目剖析 /
销售收入逐年增长,同比增长15.77% /
业代工(OSAT)营收为2137亿元,较2019年增长12.36%,占到全球
前十大代工企业未来的发展情况 /
特色工艺及封装测试创新中心(华进半导体封装先导技术研发中心有限公司)、无锡苏芯半导体
科技服务中心承办。论坛以“挑战、机遇、协同、创新”为主题,邀请来自国家
- 上一篇: 常用封装zip
- 下一篇: 请问轿车上面的承载式和非承载式的差异是什么

 热线电话:
热线电话:


